
基板にICチップを実装にフリップチップという方法がよく使われますが、しばしば温度変動による破損が問題になります。
こちらのページでは「Ansys Mechanical」のクリープ材料モデルを利用してフリップチップパッケージに対して熱応力によるひずみを評価した事例になります。クリープ材料を用いることで熱負荷を与えるたびにひずみの値が増大していく様子が確認できます。
- 解析モデル
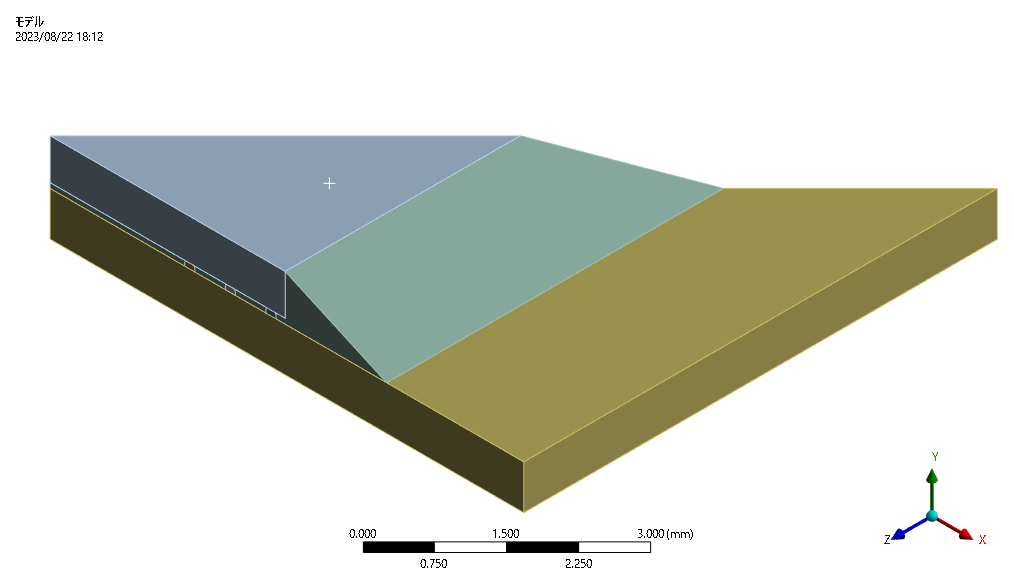 モデルはチップ・アンダーフィル・基板・はんだから構成された1/8対称モデル
モデルはチップ・アンダーフィル・基板・はんだから構成された1/8対称モデル - 解析結果


温度分布


はんだの相当クリープひずみ ひずみの時刻歴変化
著者紹介

SB C&S株式会社
C&S Engineer Voice運営事務局
最新の技術情報をお届けします!








